
 Home > 제품소개 > Negative ebeam resist
Home > 제품소개 > Negative ebeam resist
- H-SiQ - Negative E-beam Resist
- H-SiQ DescriptionApplication Guidelines
- H-SiQ is a negative tone hydrogen silesquioxane resist derived
from dry silica resin (H-SiOx) in MIBK carrier solvent for use in
electron beam lithography (EBL).
- H-SiQ is characterized by excellent pitch resolution, sensitivity
and etch resistance for direct write thin film EBL applications.
- H-SiQ is prepared on a percent by weight basis of silica resin in
semiconductor grade MIBK with concentrations ranging from
1 – 20% / wt. Prepared solutions are available in quantities
of 20 – 100 ml.- Bring H-SiQ to room temperature before opening bottle.
- H-SiQ is applied by spin coating at 1000—6000 rpm.
- H-SiQ is provided prefiltered to 0.22 um (<10%) and 0.45 um
(>10%). Additional filtration is typically not required.
If additional filtration is needed, please see the data sheet.
- Bake after spin coating at 120°C for 2 minutes for high
contrast and sensitivity at low exposure dose.
- H-SiQ is developed after EBL using your preferred HSQ
developer (TMAH or NaOH/NaCl).
- Etch resistance of the cured H-SiQ film is comparable to
traditional HSQ: 30 sccm CF4, 30 mTorr, 100 W, 33 nm/min.Thin Film Spin CurveThic Film Spin Curve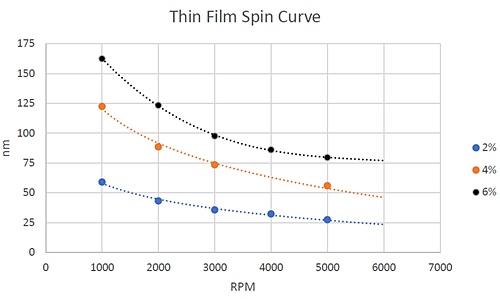
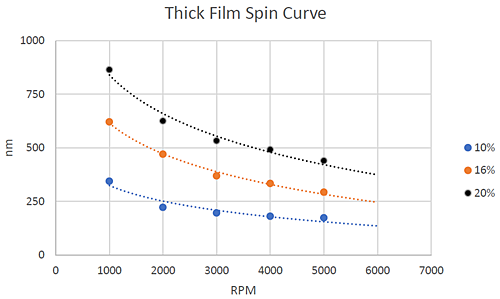
H-SiQ 6% Results